过去数十年来,为了扩增芯片的晶体管数量以推升运算效能,半导体制造技术已从1971 年10,000nm制程进步至2022年3nm 制程,逐渐逼近目前已知的物理极限,但随着人工智能、AIGC等相关应用高速发展,设备端对于核心芯片的效能需求将越来越高;在制程技术提升可能遭遇瓶颈,但是运算资源需求持续走高的情况下,透过先进封装技术提升芯片之晶体管数量就显得格外重要。


而2.5D 与3D 封装技术则是差别在堆叠方式。2.5D 封装是指将芯片堆叠于中介层之上或透过硅桥连结芯片,以水平堆叠的方式,主要应用于拼接逻辑运算芯片和HBM;3D 封装则是垂直堆叠芯片的技术,主要面向高效能逻辑芯片、SoC 制造。
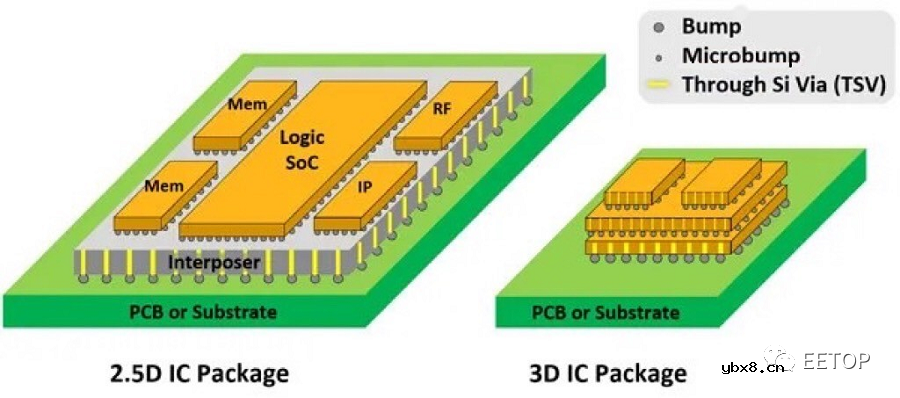
▲2.5D和3D封装的差异(图片来源:Ansys)

审核编辑:刘清
 microBUCK® 同步降压稳压器获中国人工智能...
microBUCK® 同步降压稳压器获中国人工智能...
时间:2026-03-12
 超薄MTC封装130A~300A三相桥式功率模块具有...
超薄MTC封装130A~300A三相桥式功率模块具有...
时间:2026-03-12
 如何学好单片机?
如何学好单片机?
时间:2026-03-12
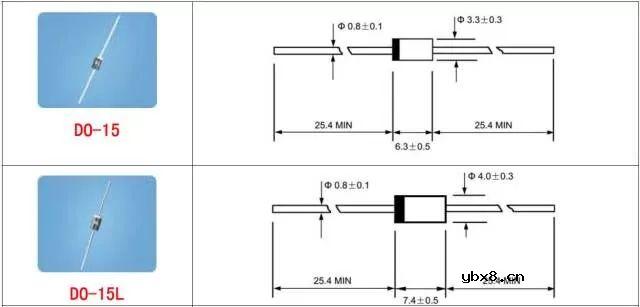 总结了60种硬件工程师常用封装实物图
总结了60种硬件工程师常用封装实物图
时间:2026-03-12
 常用电子元器件的划分与识别
常用电子元器件的划分与识别
时间:2026-03-12
 脑机接口最新科研进展,以“半侵入性”方式...
脑机接口最新科研进展,以“半侵入性”方式...
时间:2026-03-12
 国内主要碳化硅衬底供应商产能分析,与海外...
国内主要碳化硅衬底供应商产能分析,与海外...
时间:2026-03-12
 KT1025A双模蓝牙音频文件加密说明
KT1025A双模蓝牙音频文件加密说明
时间:2026-03-12
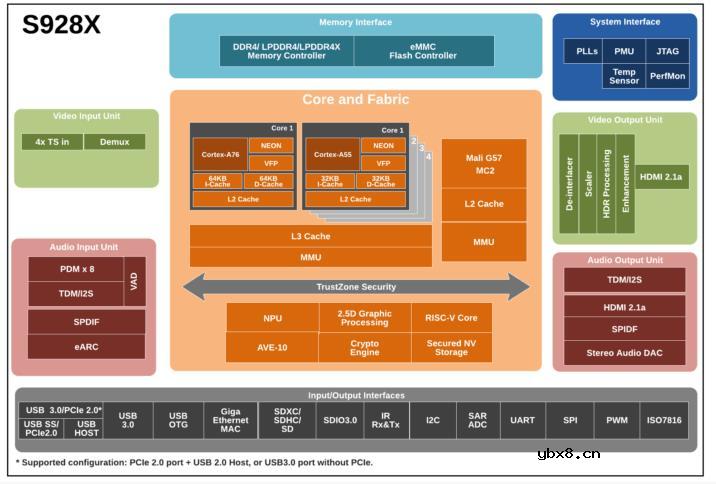 晶晨半导体8K智能机顶盒SoC芯片S928X特性解...
晶晨半导体8K智能机顶盒SoC芯片S928X特性解...
时间:2026-03-12
 纳微半导体2022年第四季度及全年财报亮眼 ...
纳微半导体2022年第四季度及全年财报亮眼 ...
时间:2026-03-12
 电阻的标称阻值和允许偏差
电阻的标称阻值和允许偏差
时间:2026-03-05
 玻璃釉电容器的结构与特点
玻璃釉电容器的结构与特点
时间:2026-03-05
 压敏电阻有正负极吗
压敏电阻有正负极吗
时间:2026-03-05
 变压器并列运行的条件浅析
变压器并列运行的条件浅析
时间:2026-03-06
 电容器入门教程
电容器入门教程
时间:2026-03-05
 关于STM32WL LSE 添加反馈电阻后无法起振的...
关于STM32WL LSE 添加反馈电阻后无法起振的...
时间:2026-03-05
 可调电阻怎么接线
可调电阻怎么接线
时间:2026-03-05
 压敏电阻坏了怎么替代
压敏电阻坏了怎么替代
时间:2026-03-05
 压敏电阻爆裂的原因分析
压敏电阻爆裂的原因分析
时间:2026-03-05
 暑期买元器件下单立减还送华为P30pro
暑期买元器件下单立减还送华为P30pro
时间:2026-03-05